深圳半导体硅片激光钻孔微小孔加工
————认证资质————
- 个人未认证
- 企业已认证
- 微信未认证
- 手机已认证
该用户其他信息
———线上沟通
与商家沟通核实商家资质
线下服务
核实商家身份所有交流确保留有证据
服务售后
有保障期的服务请与商家确定保障实效
详情
| 产地 | 北京 | 分类 | 硅片切割 |
| 切割加工最小缝隙 | 0.05mm | 加工厚度范围 | 0.1--2mm |
| 加工方式 | 激光切割 | 品牌 | HE |
| 微信号 | 13011886131 | 服务范围 | 全国 |
| 硅片大小加工范围 | 300mm | 联系人 | 张经理 |
深圳半导体硅片激光钻孔微小孔加工
硅片的分类:
硅片规格有多种分类方法,可以按照硅片直径:4寸、6寸、12寸、3英寸、2英寸;单晶生长方法:单晶硅片、多晶硅片;掺杂类型:N型、P型等参量和用途来划分种类。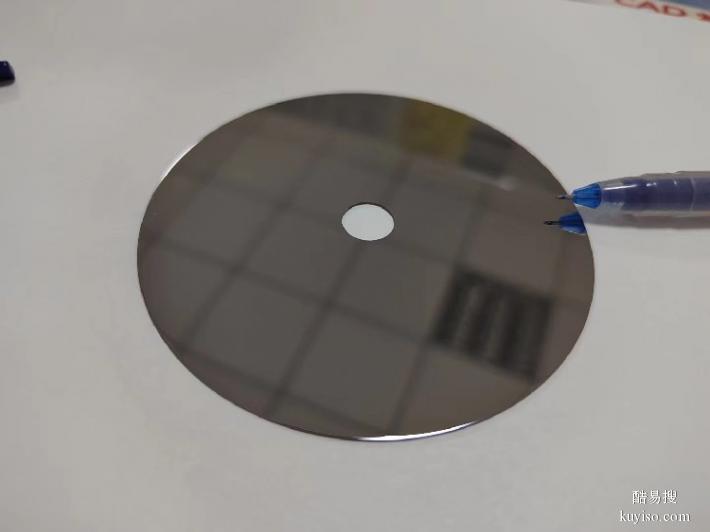
激光切割于传统机械切割硅片相比,是一种行的加工方式,有一下几点加工优势:
1、激光加工一步即可完成的、干燥对的加工过程。
2、边缘光滑整齐,不需要后续的清洁和打磨。
3、激光加工的分离过程产生高强度、自然回火的边缘,没有微小裂痕。使用激光加工避免了不可预料的裂痕和残破,提高了成品率。
激光隐形切割作为激光切割晶圆的一种方案,很好的避免了砂轮划片存在的问题。激光隐形切割是通过将脉冲激光的单个脉冲通过光学整形,让其透过材料表面在材料内部聚焦,在焦点区域能量密度较高,形成多光子吸收非线性吸收效应,使得材料改性形成裂纹。每一个激光脉冲等距作用,形成等距的损伤即可在材料内部形成一个改质层。在改质层位置材料的分子键被破坏,材料的连接变的脆弱而易于分开。切割完成后通过拉伸承载膜的方式,将产品充分分开,并使得芯片与芯片之间产生间隙。这样的加工方式避免了机械的直接接触和纯水的冲洗造成的破坏。目前激光隐形切割技术可应用于蓝宝石/玻璃/硅以及多种化合物半导体晶圆。
超薄硅片打孔是一项非常精细的工序,因为硅片较薄,打孔的时候不能损坏其表面的精度,打孔的密度、孔径大小需要达到一定的精度以及所要求的大小。
激光打孔是将光斑直径缩小到微米级,从而获得高的激光功率密度,几乎可以在任何材料实行激光打孔。其特点是可以在硬度高、质地脆或者软的材料上打孔,孔径小、加工速度快、效率高。
超薄硅片使用激光打孔可以打出小孔:1.00~3.00(mm);次小孔:0.40~1.00(mm);超小孔:0.1~0.40(mm);微孔:0.01~0.10(mm);
随着硅半导体集成电路的广泛应用,硅半导体集成电路都要用到晶圆,传统的晶圆切割方法,都是手工采用金刚石刀进行切割,在晶圆上划分出若干个圆环,在划分出的圆环上切割出面积相等或者近似相等的小圆弧体。或者采用的是非均匀圆环、同一圆心角内进行切割的切割方法,这种晶圆切割方法的耗材大,经常要更换刀具,切割出来的晶圆芯片相距的宽度比较大,不均匀,所能切割的材料单一,适用性差,效率低下。
因此晶圆激光切割的方法工作效率高、能精确地调整待切割晶圆的各个方向的位置、精度高、全自动运行,对晶圆切割的位置进行准确定位,切割出来的晶圆芯片均匀、美观,能切割多种材料,适应性强,可以避免薄晶圆因切割破裂
晶圆是制造IC的基本原料,而晶圆便是硅元素加以纯化,接着将这些纯硅制成长硅晶棒,成为制造积体电路的石英半导体的材料,再经过照相制版、研磨、抛光、切片等程序,将多晶硅融解后拉出单晶硅晶棒,然后切割成一片一片薄薄的晶圆。
2)确认收货前请仔细核验产品质量,避免出现以次充好的情况。
3)该信息由酷易搜网用户自行发布,其真实性及合法性由发布人负责,酷易搜网仅引用以供用户参考,详情请阅读酷易搜网免责条款。查看详情>
-
 张经理
您好!欢迎浏览本信息,请发送您的联系方式,以便及时解答您的咨询。
张经理
您好!欢迎浏览本信息,请发送您的联系方式,以便及时解答您的咨询。


 渝公网安备 50019002501864号
渝公网安备 50019002501864号